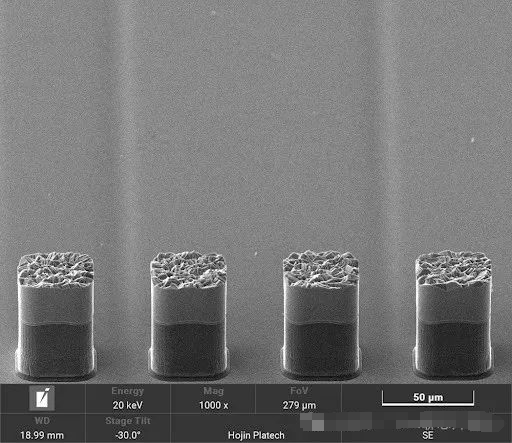
' 범프 생성 과정을 계속해서 배워 보겠습니다.
1. 웨이퍼 반입 및 청소:
프로세스를 시작하기 전에 웨이퍼 표면에는 습식 또는 건식 세척 방법으로 세척해야 하는 유기 오염물질, 입자, 산화물 층 등이 있을 수 있습니다.
2. PI-1 리소그래피: (1층 포토리소그래피: 폴리이미드 코팅 포토리소그래피)
폴리이미드(PI)는 단열재 및 지지대 역할을 하는 단열재입니다. 먼저 웨이퍼 표면에 코팅한 후 노광하고 현상한 후 마지막으로 범프의 개구부 위치가 생성됩니다.
3. Ti/Cu 스퍼터링(UBM):
UBM은 Under Bump Metallization의 약자로 주로 전도성 목적으로 사용되며 후속 전기도금을 준비합니다. UBM은 일반적으로 마그네트론 스퍼터링을 사용하여 만들어지며 Ti/Cu 시드층이 가장 일반적입니다.
4. PR-1 리소그래피(2층 포토리소그래피: 포토레지스트 포토리소그래피):
포토레지스트의 포토리소그래피는 범프의 모양과 크기를 결정하며, 이 단계에서는 전기도금할 영역을 엽니다.
5. Sn-Ag 도금:
전기도금 기술을 사용하여 주석-은 합금(Sn-Ag)이 개구부 위치에 증착되어 범프를 형성합니다. 이 시점에서 범프는 구형이 아니며 표지 이미지에 표시된 것처럼 리플로우를 거치지 않았습니다.
6. PR 스트립:
전기 도금이 완료된 후 남은 포토레지스트(PR)가 제거되어 이전에 덮여 있던 금속 시드 레이어가 노출됩니다.
7. UBM 에칭:
범프 영역을 제외하고 UBM 금속층(Ti/Cu)을 제거하고 범프 아래의 금속만 남깁니다.
8. 리플로우:
리플로우 솔더링을 통과하여 주석-은 합금 층을 녹인 후 다시 흐르게 하여 매끄러운 솔더 볼 모양을 형성합니다.
9. 칩 배치:
리플로우 납땜이 완료되고 범프가 형성된 후 칩 배치가 수행됩니다.
이로써 플립칩 프로세스가 완료되었습니다.
다음 강좌에서는 칩 배치에 대한 과정을 배워보겠습니다.

 한국어
한국어 English
English Español
Español Português
Português русский
русский français
français 日本語
日本語 Deutsch
Deutsch Tiếng Việt
Tiếng Việt Italiano
Italiano Nederlands
Nederlands ไทย
ไทย Polski
Polski Svenska
Svenska magyar
magyar Malay
Malay বাংলা
বাংলা Dansk
Dansk Suomi
Suomi हिन्दी
हिन्दी Pilipino
Pilipino Türk
Türk Gaeilge
Gaeilge عربى
عربى Indonesia
Indonesia norsk
norsk اردو
اردو čeština
čeština Ελληνικά
Ελληνικά Українська
Українська Javanese
Javanese فارسی
فارسی தமிழ்
தமிழ் తెలుగు
తెలుగు नेपाली
नेपाली Burmese
Burmese български
български ລາວ
ລາວ Latine
Latine Қазақ
Қазақ Euskal
Euskal Azərbaycan
Azərbaycan slovenský
slovenský Македонски
Македонски Lietuvos
Lietuvos Eesti Keel
Eesti Keel Română
Română Slovenski
Slovenski मराठी
मराठी Српски
Српски 简体中文
简体中文 Esperanto
Esperanto Afrikaans
Afrikaans Català
Català עִברִית
עִברִית Cymraeg
Cymraeg Galego
Galego 繁体中文
繁体中文 Latvietis
Latvietis icelandic
icelandic יידיש
יידיש Беларус
Беларус Hrvatski
Hrvatski Kreyòl ayisyen
Kreyòl ayisyen Shqiptar
Shqiptar Malti
Malti lugha ya Kiswahili
lugha ya Kiswahili አማርኛ
አማርኛ Bosanski
Bosanski Frysk
Frysk ជនជាតិខ្មែរ
ជនជាតិខ្មែរ ქართული
ქართული ગુજરાતી
ગુજરાતી Hausa
Hausa Кыргыз тили
Кыргыз тили ಕನ್ನಡ
ಕನ್ನಡ Corsa
Corsa Kurdî
Kurdî മലയാളം
മലയാളം Maori
Maori Монгол хэл
Монгол хэл Hmong
Hmong IsiXhosa
IsiXhosa Zulu
Zulu Punjabi
Punjabi پښتو
پښتو Chichewa
Chichewa Samoa
Samoa Sesotho
Sesotho සිංහල
සිංහල Gàidhlig
Gàidhlig Cebuano
Cebuano Somali
Somali Точик
Точик O'zbek
O'zbek Hawaiian
Hawaiian سنڌي
سنڌي Shinra
Shinra հայերեն
հայերեն Igbo
Igbo Sundanese
Sundanese Lëtzebuergesch
Lëtzebuergesch Malagasy
Malagasy Yoruba
Yoruba